
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
На основе 8-дюймовой технологии печи для выращивания монокристаллов карбида кремния.
2024-07-11
Карбид кремния — один из идеальных материалов для изготовления высокотемпературных, высокочастотных, мощных и высоковольтных устройств. Важным направлением развития с целью повышения эффективности производства и снижения затрат является подготовка крупногабаритных подложек из карбида кремния. Ориентируясь на технологические требования8-дюймовый рост монокристалла карбида кремния (SIC), был проанализирован механизм роста метода физического переноса паров карбида кремния (PVT), система нагрева (направляющее кольцо TaC, тигель с покрытием TaC,Кольца с покрытием TaC, пластина с покрытием TaC, трехлепестковое кольцо с покрытием TaC, трехлепестковый тигель с покрытием TaC, держатель с покрытием TaC, пористый графит, мягкий войлок, жесткий фетр с SiC-покрытием токоприемник роста кристаллов и другиеЗапасные части для процесса выращивания монокристаллов SiCпредоставлены VeTek Semiconductor), были изучены технология вращения тигля и управления технологическими параметрами печи для выращивания монокристаллов карбида кремния, а также были успешно подготовлены и выращены 8-дюймовые кристаллы с помощью анализа моделирования теплового поля и технологических экспериментов.
0 Введение
Карбид кремния (SiC) является типичным представителем полупроводниковых материалов третьего поколения. Он имеет такие преимущества в производительности, как большая ширина запрещенной зоны, более высокое электрическое поле пробоя и более высокая теплопроводность. Он хорошо работает в полях высоких температур, высокого давления и высоких частот и стал одним из основных направлений развития в области технологии полупроводниковых материалов. Он имеет широкий спектр прикладных потребностей в транспортных средствах на новой энергии, производстве фотоэлектрической энергии, железнодорожном транспорте, интеллектуальных сетях, связи 5G, спутниках, радарах и других областях. В настоящее время при промышленном выращивании кристаллов карбида кремния в основном используется физический перенос пара (PVT), который включает в себя сложные проблемы взаимодействия мультифизических полей многофазного, многокомпонентного, многократного переноса тепла и массы и взаимодействия магнитоэлектрического теплового потока. Таким образом, разработка системы выращивания PVT сложна, а измерение и контроль параметров процесса во времяпроцесс роста кристалловзатруднен, что приводит к затруднению контроля дефектов качества выращенных кристаллов карбида кремния и малому размеру кристаллов, в результате чего стоимость устройств с карбидом кремния в качестве подложки остается высокой.
Оборудование для производства карбида кремния является основой технологии карбида кремния и промышленного развития. Технический уровень, технологические возможности и независимая гарантия печи для выращивания монокристаллов карбида кремния являются ключом к развитию карбидокремниевых материалов в направлении больших размеров и высокого выхода, а также являются основными факторами, побуждающими полупроводниковую промышленность третьего поколения к развиваться в направлении малозатратности и масштабности. В настоящее время разработка высоковольтных, мощных и высокочастотных устройств из карбида кремния достигла значительного прогресса, однако эффективность производства и стоимость подготовки устройств станут важным фактором, ограничивающим их развитие. В полупроводниковых устройствах с монокристаллом карбида кремния в качестве подложки наибольшую долю составляет величина подложки, около 50%. Разработка крупногабаритного высококачественного оборудования для выращивания кристаллов карбида кремния, повышение выхода и скорости роста монокристаллических подложек карбида кремния, а также снижение производственных затрат имеют ключевое значение для применения соответствующих устройств. Для увеличения поставок производственных мощностей и дальнейшего снижения средней стоимости устройств из карбида кремния одним из важных способов является расширение размеров подложек из карбида кремния. В настоящее время основной международный размер подложки из карбида кремния составляет 6 дюймов, и он быстро увеличивается до 8 дюймов.
Основные технологии, которые необходимо решить при разработке 8-дюймовых печей для выращивания монокристаллов карбида кремния, включают: 1) Разработка крупногабаритной структуры теплового поля для получения меньшего радиального градиента температуры и большего продольного градиента температуры, подходящего для выращивания. из 8-дюймовых кристаллов карбида кремния. 2) Механизм вращения тигля большого размера и механизма подъема и опускания катушки, благодаря чему тигель вращается во время процесса роста кристаллов и перемещается относительно катушки в соответствии с требованиями процесса, чтобы обеспечить консистенцию 8-дюймового кристалла и облегчить рост и толщину. . 3) Автоматический контроль параметров процесса в динамических условиях, отвечающих потребностям процесса выращивания высококачественных монокристаллов.
1 Механизм роста кристаллов PVT
Метод PVT заключается в получении монокристаллов карбида кремния путем размещения источника SiC на дне цилиндрического тигля из плотного графита, а затравочного кристалла SiC - вблизи крышки тигля. Тигель нагревается до 2300–2400 ℃ за счет радиочастотной индукции или сопротивления и изолируется графитовым войлоком илипористый графит. Основными веществами, транспортируемыми от источника SiC к затравочному кристаллу, являются молекулы Si, Si2C и SiC2. Температуру затравочного кристалла поддерживают немного ниже, чем температуру нижнего микропорошка, и в тигле формируют осевой градиент температуры. Как показано на рисунке 1, микропорошок карбида кремния сублимируется при высокой температуре с образованием реакционных газов различных компонентов газовой фазы, которые под действием температурного градиента достигают затравочного кристалла с более низкой температурой и кристаллизуются на нем, образуя цилиндрический кристалл. слиток карбида кремния.
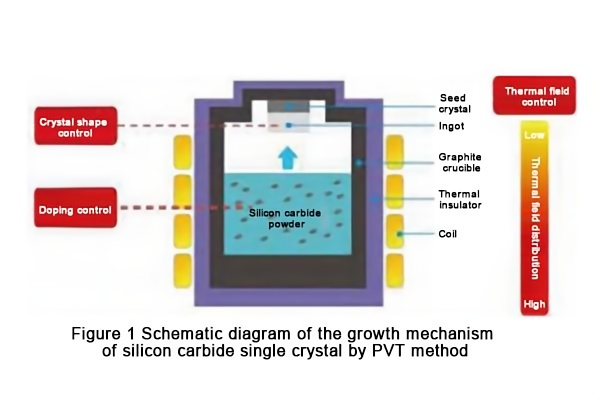
Основными химическими реакциями роста PVT являются:
SiC(т)⇌Si(г)+C(т) (1)
2SiC⇌Si2C(г)+C(т) (2)
2SiC⇌SiC2(г)+Si(ж,г) (3)
SiC(ы)⇌SiC(г) (4)
Характеристики PVT-роста монокристаллов SiC:
1) Существует две границы раздела газ-твердое тело: одна — граница раздела газ-порошок SiC, а другая — граница раздела газ-кристалл.
2) Газовая фаза состоит из двух типов веществ: одни — инертные молекулы, введенные в систему; другой — компонент газовой фазы SimCn, образующийся в результате разложения и сублимациипорошок карбида кремния. Компоненты газовой фазы SimCn взаимодействуют друг с другом, и часть так называемых кристаллических компонентов газовой фазы SimCn, отвечающих требованиям процесса кристаллизации, вырастет в кристалл SiC.
3) В твердом порошке карбида кремния твердофазные реакции будут происходить между частицами, которые не сублимировались, включая некоторые частицы, образующие пористые керамические тела в результате спекания, некоторые частицы, образующие зерна с определенным размером частиц и кристаллографической морфологией в результате реакций кристаллизации, а некоторые частицы карбида кремния, превращающиеся в богатые углеродом частицы или углеродные частицы вследствие нестехиометрического разложения и сублимации.
4) В процессе роста кристаллов будут происходить два фазовых изменения: одно заключается в том, что частицы твердого порошка карбида кремния преобразуются в компоненты газовой фазы SimCn посредством нестехиометрического разложения и сублимации, а другое заключается в том, что компоненты газовой фазы SimCn преобразуются в решетчатые частицы путем кристаллизации.
2 Конструкция оборудования Как показано на рисунке 2, печь для выращивания монокристаллов карбида кремния в основном включает в себя: узел верхней крышки, узел камеры, систему нагрева, механизм вращения тигля, механизм подъема нижней крышки и электрическую систему управления.

2.1 Система нагрева Как показано на рисунке 3, система нагрева использует индукционный нагрев и состоит из индукционной катушки,графитовый тигель, изоляционный слой(жесткий фетр, мягкий фетр) и т. д. Когда переменный ток средней частоты проходит через многовитковую индукционную катушку, окружающую графитовый тигель снаружи, в графитовом тигле образуется индуцированное магнитное поле той же частоты, генерирующее индуцированную электродвижущую силу. Поскольку материал тигля из графита высокой чистоты обладает хорошей проводимостью, на стенках тигля генерируется индуцированный ток, образующий вихревой ток. Под действием силы Лоренца индуцированный ток со временем сойдется на внешней стенке тигля (т.е. скин-эффект) и постепенно ослабнет в радиальном направлении. Благодаря существованию вихревых токов на внешней стенке тигля генерируется джоулево тепло, становящееся источником нагрева ростовой системы. Размер и распределение джоулева тепла напрямую определяют температурное поле в тигле, что, в свою очередь, влияет на рост кристалла.
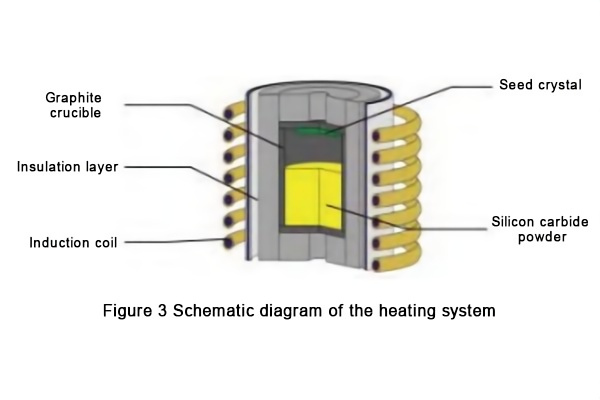
Как показано на рисунке 4, индукционная катушка является ключевой частью системы отопления. Он использует два набора независимых катушек и оснащен механизмами перемещения верхней и нижней точности соответственно. Большую часть потерь электрического тепла всей системы отопления несет змеевик, поэтому необходимо выполнить принудительное охлаждение. Змеевик намотан медной трубкой и охлаждается внутри водой. Диапазон частот наведенного тока составляет 8~12 кГц. Частота индукционного нагрева определяет глубину проникновения электромагнитного поля в графитовый тигель. В механизме движения катушки используется винтовая пара с приводом от двигателя. Индукционная катушка взаимодействует с индукционным источником питания для нагрева внутреннего графитового тигля для достижения сублимации порошка. В то же время мощность и относительное положение двух наборов катушек контролируются, чтобы температура затравочного кристалла была ниже, чем температура нижнего микропорошка, образуя осевой градиент температуры между затравочным кристаллом и порошком в тигля и формирования разумного радиального градиента температуры на кристалле карбида кремния.

2.2. Механизм вращения тигля. При выращивании крупногабаритныхмонокристаллы карбида кремнияТигель в вакуумной среде полости продолжает вращаться в соответствии с требованиями процесса, а градиентное тепловое поле и состояние низкого давления в полости должны поддерживаться стабильными. Как показано на рисунке 5, для достижения стабильного вращения тигля используется зубчатая пара с приводом от двигателя. Уплотняющая конструкция с магнитной жидкостью используется для динамического уплотнения вращающегося вала. В уплотнении магнитной жидкости используется цепь вращающегося магнитного поля, образованная между магнитом, башмаком магнитного полюса и магнитной втулкой, для прочной адсорбции магнитной жидкости между кончиком башмака полюса и втулкой с образованием жидкостного кольца в форме уплотнительного кольца, полностью блокирующего зазор для достижения цели герметизации. Когда вращательное движение передается из атмосферы в вакуумную камеру, устройство динамического уплотнения с жидким уплотнительным кольцом используется для преодоления недостатков легкого износа и короткого срока службы твердого уплотнения, а жидкая магнитная жидкость может заполнить все герметичное пространство. тем самым блокируя все каналы, через которые может происходить утечка воздуха, и добиваясь нулевой утечки в двух процессах движения и остановки тигля. Магнитная жидкость и опора тигля имеют конструкцию с водяным охлаждением, чтобы обеспечить возможность применения магнитной жидкости и тигля при высоких температурах и достичь стабильности состояния теплового поля.

2.3 Механизм подъема нижней крышки
Механизм подъема нижней крышки состоит из приводного двигателя, ШВП, линейной направляющей, подъемной скобы, крышки печи и кронштейна крышки печи. Двигатель приводит в движение кронштейн крышки печи, соединенный с парой винтовых направляющих через редуктор, обеспечивая перемещение нижней крышки вверх и вниз.
Механизм подъема нижней крышки облегчает установку и снятие крупногабаритных тиглей, а главное обеспечивает надежность герметизации нижней крышки печи. В течение всего процесса камера имеет стадии изменения давления, такие как вакуум, высокое давление и низкое давление. Состояние сжатия и уплотнения нижней крышки напрямую влияет на надежность процесса. Если уплотнение выйдет из строя под действием высокой температуры, весь процесс будет отменен. С помощью сервопривода и ограничительного устройства двигателя контролируется герметичность узла нижней крышки и камеры для достижения наилучшего состояния сжатия и уплотнения уплотнительного кольца камеры печи для обеспечения стабильности технологического давления, как показано на рисунке 6. .
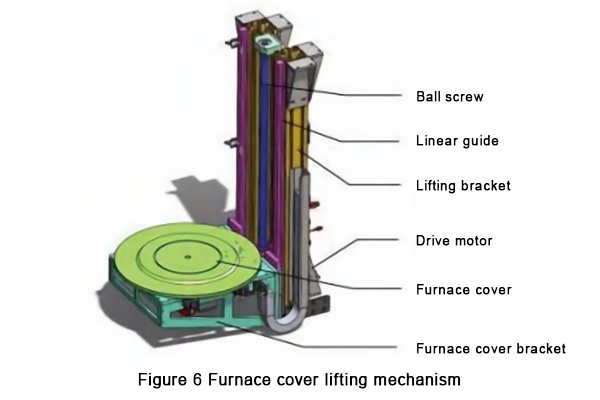
2.4 Электрическая система управления Во время роста кристаллов карбида кремния электрическая система управления должна точно контролировать различные параметры процесса, в основном включая высоту положения катушки, скорость вращения тигля, мощность нагрева и температуру, различные потоки впуска специального газа и открытие пропорциональный клапан.
Как показано на рисунке 7, система управления использует программируемый контроллер в качестве сервера, который подключен к сервоприводу через шину для реализации управления движением катушки и тигля; он подключается к контроллеру температуры и контроллеру расхода через стандартный MobusRTU для реализации контроля температуры, давления и расхода специального технологического газа в режиме реального времени. Он устанавливает связь с программным обеспечением для настройки через Ethernet, обменивается системной информацией в режиме реального времени и отображает различную информацию о параметрах процесса на главном компьютере. Операторы, технологический персонал и менеджеры обмениваются информацией с системой управления через человеко-машинный интерфейс.

Система управления осуществляет сбор всех полевых данных, анализ рабочего состояния всех исполнительных механизмов и логической взаимосвязи между механизмами. Программируемый контроллер получает инструкции главного компьютера и осуществляет управление каждым исполнительным механизмом системы. Стратегия выполнения и безопасности меню автоматического процесса выполняется программируемым контроллером. Стабильность программируемого контроллера обеспечивает стабильность и безопасность работы меню процесса.
Верхняя конфигурация поддерживает обмен данными с программируемым контроллером в режиме реального времени и отображает полевые данные. Он оснащен рабочими интерфейсами, такими как управление нагревом, регулирование давления, управление газовым контуром и управление двигателем, а значения настроек различных параметров можно изменить на интерфейсе. Мониторинг параметров тревоги в режиме реального времени, отображение тревоги на экране, запись времени и подробные данные о возникновении и восстановлении тревоги. Запись в реальном времени всех данных процесса, содержимого экрана и времени работы. Совместное управление различными параметрами процесса реализуется с помощью базового кода внутри программируемого контроллера, и можно реализовать максимум 100 этапов процесса. Каждый этап включает более десятка параметров процесса, таких как время работы процесса, заданная мощность, заданное давление, поток аргона, поток азота, поток водорода, положение тигля и скорость тигля.
3 Анализ моделирования теплового поля
Создана модель анализа теплового поля. На рис. 8 представлена карта температурного облака в камере выращивания тигля. Чтобы обеспечить температурный диапазон роста монокристалла 4H-SiC, центральная температура затравочного кристалла рассчитывается равной 2200 ℃, а краевая температура — 2205,4 ℃. В это время центральная температура верхней части тигля составляет 2167,5 ℃, а самая высокая температура области порошка (стороной вниз) составляет 2274,4 ℃, образуя осевой градиент температуры.

Распределение радиального градиента кристалла показано на рисунке 9. Более низкий боковой температурный градиент поверхности затравочного кристалла может эффективно улучшить форму роста кристалла. Текущая расчетная начальная разница температур составляет 5,4 ℃, а общая форма почти плоская и слегка выпуклая, что может соответствовать радиальной точности контроля температуры и требованиям однородности поверхности затравочного кристалла.

Кривая разности температур между поверхностью сырья и поверхностью затравочного кристалла показана на рисунке 10. Центральная температура поверхности материала составляет 2210 ℃, а между поверхностью материала и затравкой образуется продольный градиент температуры 1 ℃/см. поверхность кристалла, которая находится в разумных пределах.
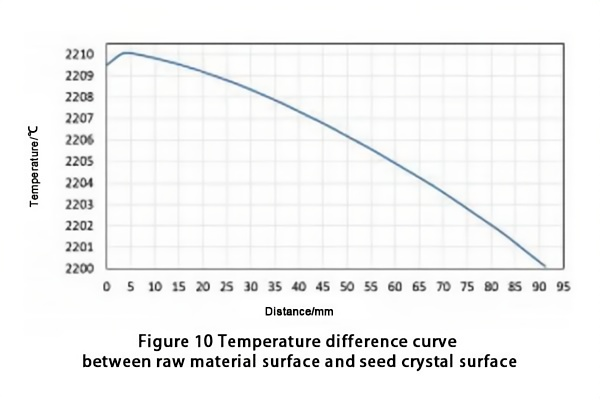
Предполагаемая скорость роста показана на рисунке 11. Слишком высокая скорость роста может увеличить вероятность возникновения таких дефектов, как полиморфизм и дислокация. Текущая расчетная скорость роста близка к 0,1 мм/ч, что находится в разумных пределах.

Путем анализа и расчетов моделирования теплового поля обнаружено, что температура в центре и температура на краях затравочного кристалла соответствуют радиальному температурному градиенту кристалла в 8 дюймов. При этом верх и низ тигля образуют осевой градиент температуры, соответствующий длине и толщине кристалла. Текущий метод нагрева системы выращивания позволяет выращивать 8-дюймовые монокристаллы.
4 Экспериментальный тест
Используя этопечь для выращивания монокристаллов карбида кремнияНа основе температурного градиента моделирования теплового поля путем регулировки таких параметров, как температура верхней части тигля, давление в полости, скорость вращения тигля и относительное положение верхней и нижней катушек, был проведен тест на рост кристаллов карбида кремния. и был получен 8-дюймовый кристалл карбида кремния (как показано на рисунке 12).

5. Вывод
Изучены ключевые технологии выращивания 8-дюймовых монокристаллов карбида кремния, такие как градиентное тепловое поле, механизм движения тигля и автоматическое управление параметрами процесса. Тепловое поле в камере выращивания тигля было смоделировано и проанализировано для получения идеального температурного градиента. После тестирования метод индукционного нагрева с двойной катушкой может удовлетворить рост крупногабаритных изделий.кристаллы карбида кремния. Исследования и разработки этой технологии обеспечивают технологию оборудования для получения 8-дюймовых кристаллов карбида и обеспечивают основу оборудования для перехода индустриализации карбида кремния с 6 дюймов на 8 дюймов, повышая эффективность роста карбидокремниевых материалов и снижая затраты.



